Основным элементом приборов большой мощности обычно является тонкая одно-кристаллических кремниевая пластина диаметром 75-125 мм, а иногда и 150 мм в диаметре. Прибор на базе пластины одного и того же диаметра может выполняться на высокое напряжение и маленький ток, или наоборот.
Транзисторы - это группа трехслойных устройств. Транзистор переходит в состояние проводимости в прямом направлении, когда на одном из его электродов, называемым коллектором, появляется положительное напряжение относительно другого электрода, называемого эмиттером, при условии подачи на третий электрод, называемым базой, включающего сигнала тока или напряжения. В случае, если подаваемый на базу сигнал тока или напряжения меньше необходимого для полного включения устройства, в устройстве будет протекать ток до тех пор, пока будет приложено напряжение к аноду относительно катода. Транзисторы нашли широкое применение в системах малой и средней мощности. Один из транзисторов, известный как биполярный транзистор с изолированным затвором (IGBT) был специально разработан для широкого применения в установках средней и большой мощности, от нескольких МВт до нескольких десятков МВт. Таким образом, IGBT является достаточно важным элементом для устройств FACTS. Метало-оксидный полевой транзистор MOS (MOSFET) является другим типом транзистора, который используется только в системах низкого напряжения, но для которого характерна возможность очень быстрого включения и выключения, а так же данный тип транзистора часто используется как усилительное устройство затвора мощных тиристоров.
Транзисторами называют группу трехслойных (с двумя p-n переходами) устройств. В данном разделе рассмотрены основные принципы работы транзисторов для лучшего понимания работы мощных устройств.
Эквивалентом транзистора является два встречно- включенных p-n диодных перехода. Существует два типа транзисторов:
- Pnp транзистор (Рис.1 (a, b)), который соответствует двум последовательно включенным переходам рn (диод) и np (обращенный диод), таким образом, что образуется прибор, состоящий из двух p слоев и n слоя между ними. Анод (эмиттер) – p слой выполняется широким, слой n (база) – узким, а катод (коллектор) – p слой – узким с большим количеством примесей.
- Npn транзистор (Рис. 1 (c, d)), который соответствует двум расположенным друг над другом nр (обращенный диод) и рn (диод), таким образом, что образуется прибор, состоящий из двух n слоев и р слоя между ними.
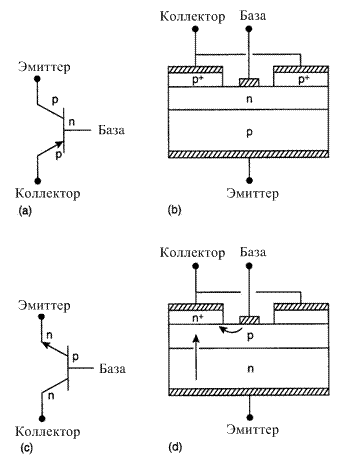
Рис. 1. Транзистор: (а)условное обозначение, (p-n-p), (b)p-n-p структура, (c) условное обозначение(n-p-n), (d) n-p-n структура.
Рассмотрим принцип действия только npn транзистора, т.к. транзисторы большой мощности относятся именно к этому типу, один из внешних слоев n, выполненный с добавлением большого количества примесей (n+), называется эмиттером, другой n слой называется коллектором и средний p слой называется базой. В случае, когда при включении внешнего задающего напряжения коллектор имеет положительную полярность относительно эмиттера, в устройстве отсутствуют какие-либо электрические токи, так как происходит запирание прибора обедненным слоем, сформированным на границе np перехода на стороне коллектора. Это соединение сделано для возможности запирания высокого напряжения с низким добавлением примесей в p слое. Таким образом, при возникновении другого небольшого внешнего напряжения, приложенного к базе (затвору), при ее положительной полярности относительно эмиттера, возникнет поток электронов от n+ эмиттера к базе p (ток от затвора к эмиттеру). При движении электронов от n+ эмиттера к базе, происходит также ускорение электронов электрическим полем обедненного слоя к коллектору; направления протекания токов через прибор показаны стрелками на Рис.1 (d).
Так как количество полученных электронов от n+ слоя является функцией тока базы, происходит ограничение (насыщение) электрического тока, значение которого определяется напряжением обедненного слоя. На Рис.2 показы характеристики проводимости устройства в прямом направлении, в виде зависимости тока устройства от напряжения при различных значениях тока базы. Ток базы определяет ток насыщения устройства. В нормальном режиме работы при больших токах базы, ток и падение напряжение в прямом направлении силовой установке будут ограничены линией насыщения слева от кривых, таким образом, падение напряжения и, следовательно, потери будут маленькими. Но если ток базы ограничен, часть падения напряжения будет приходиться на само устройство, и его ток будет ограничен линией насыщения для соответствующего тока базы. Эта особенность используется в преобразователях малой мощности для ограничения тока при внешней аварии, после чего осуществляется быстрое выключение прибора безопасным способом.
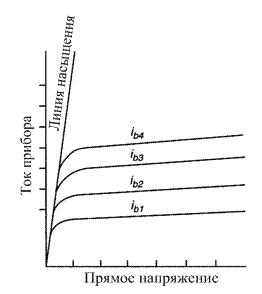
Рис. 2. Вольтамперная характеристика транзистора для разных значений тока базы.
Необходимо отметить, что в силовых приборах пластина выполняется с большим числом параллельных элементов базы, пронизывающих верхний слой, и в действительности мощный транзистор может состоять из большого количества параллельно соединенных устройств небольшой мощности.
Из-за относительно низкого коэффициента усиления (отношения тока базы к току прибора), устройства выполняются с каскадным усилением, как показано на Рис.3. Такие транзисторы получили название транзисторы Дарлингтона.

Рис. 3. Транзистор с каскадным усилением.
Существует много конструкций (типов) транзисторов. Транзистор, характеризующийся большой скоростью коммутации и низкими коммутационными потерями получил название полевой транзистор со структурой металл-оксид-полупроводник (МОSFET), в котором управление затвором осуществляется в большей степени электрическим полем (напряжением), чем током. Это обеспечивается емкостной связью между затвором и прибором. На Рис.4 показана структура и эквивалентная схема данного типа транзистора. Транзисторы МОSFET нашли широкое применение в маломощных устройствах (несколько кВт) и не используются в установках большой мощности. Однако, они применяются совместно с усовершенствованными GTO.
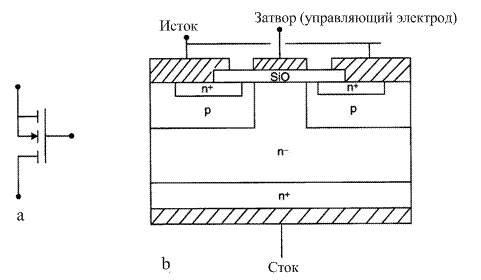
Рис.4. МОSFET: a -условное обозначение МОSFET, b- структура MOSFET.
МОSFET может быть выполнен на базе pnp или npn структуры, на Рис.4 показана только npn структура. Прибор выполнен с диэлектрическим слоем оксида кремния (SiO), который осуществляет соединение между металлическим контактом затвора, n+ и p переходами. Основным преимуществом затвора МОS является применения напряжения, вместо тока, относительно источника для полного или частичного запирания устройства путем создания пространственного заряда вокруг небольшой зоны затвора. При приложении к затвору достаточного положительного напряжение относительно эмиттера, под действием этого электрического поля осуществляется движение электронов из n+ слоя в p. Таким образом, открывается ближайший к затвору канал, который, в свою очередь, обеспечивает протекание тока от стока (коллектора) к источнику (эмиттеру).
На стороне стока в МОSFET вводиться большое количество добавок для создания n+ буфера ниже слоя проводимость дрейфа n-. В диодах этот буфер сдерживает расширение обедненного слоя для предотвращения его соприкосновения с электродом, выравнивает напряжение поперек n- слоя, а также способствует уменьшению падения напряжения в режиме проводимости. Наличие буферного слоя характеризует прибор как асимметричный с довольно низким обратным напряжением.
Для затвора транзистора МОSFET характерно маленькое потребление энергии, большая скорость коммутации и маленькие коммутационные потери. К сожалению, МОSFET обладают высоким сопротивлением в режиме проводимости в прямом направлении, а следовательно, и высокими постоянными потерями, что делает невозможным их использование в силовых установках, но они нашли широкое применение в качестве усилительных устройств затворов.
Транзисторы МОSFET имеют вольтамперные характеристики, аналогичные показанным на Рис.2; однако, ток базы заменен напряжением затвора.
2. БИПОЛЯРНЫЙ ТРАНЗИСТОР С ИЗОЛИРОВАННЫМ ЗАТВОРОМ (IGBT).
Биполярный транзистор с изолированным затвором (IGBT) является современным энергетическим транзистором. Он работает как транзистор, и предназначен для эксплуатации при больших напряжениях и токах, а также характеризуется небольшим падением напряжения в состоянии проводимости.
IGBT - это прибор, который отчасти является тиристором, но разработан таким образом, что он не переходит в состояние полной проводимости (что эквивалентно падению напряжения на одном переходе), вместо этого IGBT в отпертом состоянии работает как транзистор. Кроме этого, прибор имеет интегрированную МОS структуру с изолированным затвором, подобно МОSFET. Поперечный разрез его структуры и эквивалентная схема показаны на Рис.5. Подобно тиристорам и GTO, прибор имеет двух - транзисторную структуру. Но включение и выключение осуществляется структурой MOSFET через ее npn транзистор, вместо np эммитерного затвора верхнего npn транзистора. При включении осуществляется протекание тока через базу к эмиттеру npn транзистора, как в тиристоре, однако его недостаточно для образования лавины, которая способствовало бы к переходу в состояние полной проводимости. Как показано на Рис.5, соединение база – эмиттер шунтировано активным сопротивлением, которое встроено в структуру устройства. Через это сопротивление протекает часть катодного тока.
Рис.5. Биполярный транзистор с изолированным затвором (IGBT): a - условное обозначение IGBT, b - эквивалентная схема IGBT и c- структура IGBT.
На представленной структуре прибора верхний n+ слой MOS является источником n- носителей заряда, p-слой является базой, n--слой является дрейфовой областью, нижний p+ -буферный слой, и наконец p+ - слой является подложкой. Подобно МОSFET, для включения прибора необходимо наличие положительной полярности затвора относительно эмиттера, тогда осуществляется движение n носителей заряда в p канал около области затвора, которые прямо смещаются к базе npn-транзистора, который таким образом включается. Включение IGBT осуществляется только приложением положительного напряжения к базе, т.е. при открытии канала для n носителей заряда, а выключение при снятии напряжения с базы, т.е для закрытия канала, что приводит к очень простому контуру управления. В принципе, это может быть достигнуто и в MTOS и ETOS, если бы МОSFET были также добавлены и для включения.
Учитывая комплексную технологию МОS на полной поверхности устройства, IGBT выполняются размером приблизительно 1 см2. Для создания устройств большой мощности используется параллельное соединение нескольких IGBT, объединенных общим корпусом, имеющих вид одиночного устройства.
Преимуществом IGBT является быстрое включение и выключение, так как оно аналогично прибору с основными носителями заряда (электронами). Поэтому оно может использоваться в преобразователях широтно-импульсной модуляции (PWM), работающих на высокой частоте. С другой стороны, будучи транзисторным устройством, IGBT характеризуется большим падением напряжения в прямом направлении по сравнению с приборами тиристорного типа, таких как GTO. Однако IGBT является основным прибором, используемым в промышленных целях, и достиг необходимых параметров для применения в устройствах с номинальной мощностью 10 МВт или более.
Транзисторные приборы, такие как MOSFET и IGBT, потенциально имеют возможность ограничивать предельный ток путем управления напряжением затвора. В случае такого токоограничения, потери в устройстве очень высоки, и при использовании устройства в системах большой мощности токоограничивающее воздействие может осуществляться только в течение очень коротких периодов, т.е. нескольких микросекунд. Однако, этого времени может быть достаточно для срабатывания других систем защиты для безопасного выключения устройств. Эта особенность чрезвычайно важна в преобразователях, выполненных на базе источников напряжения, в которых возрастание тока замыкания до больших значений осуществляется очень быстро из-за наличия мощного конденсатора постоянного тока в преобразователе. С другой стороны, при быстродействующем управлении, сочетающемся с возможностью быстрого выключения в усовершенствованных GTO, эффективное гашение тока может быть достигнуто в пределах 2-3 микросекунд. Этот метод также позволяет избежать в этих приборах мощного выделения энергии и в состоянии уменьшить его используемую мощность. Время выключения обычного GTO, как правило, слишком велико для быстродействующего защитного отключения. В сетях малой мощности устройства IGBT постепенно заменяет обычные GTO, по мере того, как параметры приборов, состоящих из параллельно соединенных IGBT, повышаются. Это происходит потому, что обычные GTO имеют ряд серьезных недостатков, а именно большое энергопотребление цепей затвора, медленную коммутацию и высокие коммутационные потери. Развитие GTO в MTO, ETO и IGCT/GCT показало, что они являются результатом разрешения предыдущих не устраненных проблем, связанных с построением цепей затвора и паразитными индуктивностями в контуре затвор - катод.
IGBT имеет ряд собственных ограничений, включая: большое падение напряжения в прямом направлении, сложности с обеспечением двустороннего охлаждения, свойствами множественных MOS, размещенных на пластинах, что ограничивает возможности увеличения запираемого напряжения. Для производства IGBT необходимы более чистые производственные помещения.
Главными преимуществами IGBT, используемыми в устройствах большой мощности, являются небольшие коммутационные потери, быстрая коммутация и возможность токоограничения. Однако, с усовершенствованными GTO и MCT (рассматриватся в следующем разделе), существует перспектива их использования в разнообразных устройствах FACTS.
С другой стороны, будущий результат часто зависит от конъюнктуры рынка и объема продаж, что в свою очередь, способствует увеличению производства IGBT для систем большой мощности.
Источник:Hingorani N., Gyugyi L. «Understanding FACTS» - IEEE Press - Wiley, 2000. (Chapter 2. «Powersemiconductordevices»)